اهمیت اندازهگیری ضخامت لایههای نازک
لایههای نازک، لایهها یا پوششهایی با ضخامتهای در محدوده میکرومتر یا نانومتر هستند که به طور گسترده در صنایع مختلف از جمله الکترونیک، فناوری نانو، انرژی و پوششهای صنعتی مورد استفاده قرار میگیرند. یکی از چالشهای اصلی در کار با این لایهها، اندازهگیری دقیق ضخامت آنهاست که در کنترل فرآیند لایهنشانی بخار فیزیکی (physical vapor deposition)، مترولوژی و تحقیقات مواد نقش اساسی دارد.
انتخاب روش مناسب برای اندازهگیری ضخامت لایه نازک
اندازهگیری ضخامت لایه نازک میتواند به روشهای مختلفی انجام شود؛ میتوان ضخامت را در محل (در حین لایهنشانی) و یا خارج از محل (اندازهگیری پس از لایهنشانی که اغلب برای کالیبراسیون و مترولوژی با دقت بالا استفاده میشوند) پایش نمود، که هر کدام مزایا و معایب خاص خود را دارند. انتخاب روش مناسب اندازهگیری ضخامت به خواص نوری و الکتریکی لایه و محدوده ضخامت آن، دقت مورد نیاز، محدودیتهای فرآیند (در خلاء یا محیط اتمسفر) و اینکه آیا اندازهگیری باید غیرمخرب باشد یا خیر، بستگی دارد. در این مقاله، روشهای مختلف اندازهگیری ضخامت لایه را بررسی خواهیم کرد.
۱. روشهای نوری
یکی از سادهترین و پرکاربردترین روشها برای اندازهگیری ضخامت لایههای نازک، استفاده از ابزارهای نوری است. در این روش از خاصیت بازتاب نور از یک سطح استفاده میشود. بازتاب پرتوهای نور ممکن است منجر به تغییر قطبش میدان الکتریکی پرتوها و تشکیل الگوهای تداخلی شود که از طریق آنها میتوان ضخامت لایه را محاسبه کرد.
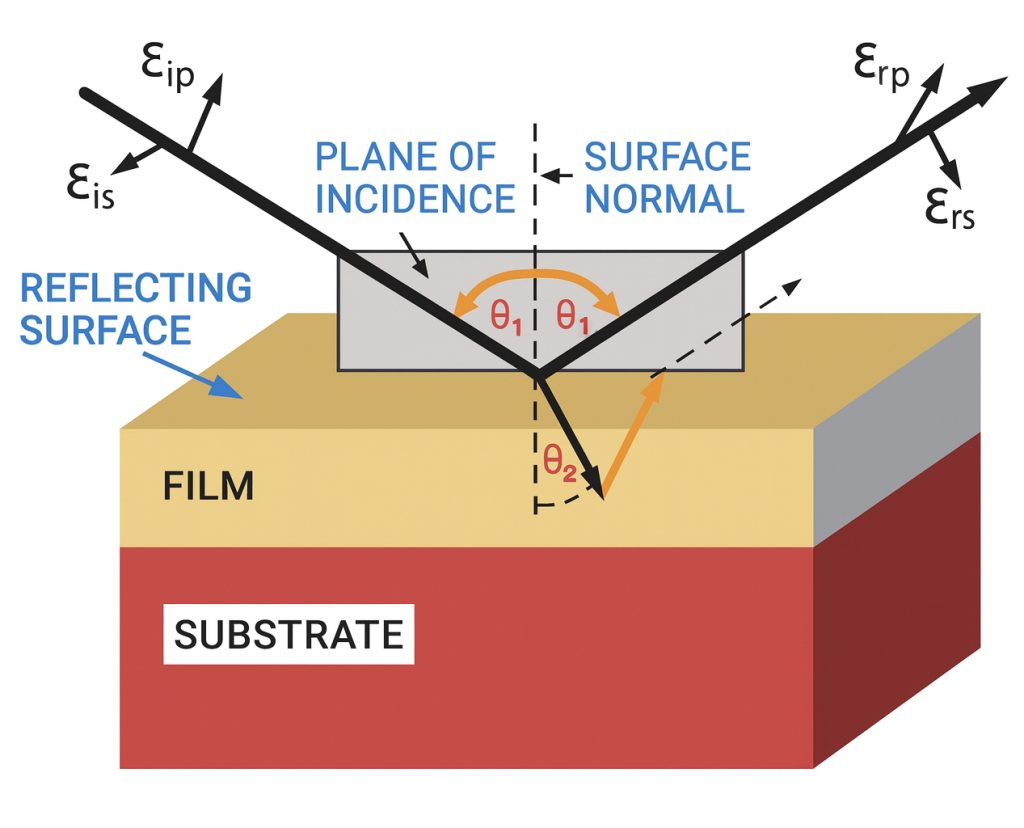
۱.۱. بازتابسنجی نور سفید
اگر نورهای منعکس شده از لایه و زیرلایه زیرین به درستی تداخل کنند، الگوهای تداخلی قابل مشاهده خواهند بود. با دانستن ضریب شکست لایه نازک، میتوان ضخامت لایه را با پایش درجای تغییرات این الگوها تعیین کرد. بازتابسنجی نور سفید یک روش اندازهگیری ضخامت غیرمخرب با دقت زیر نانومتر است که معمولاً در سیستمهای PVD صنعتی استفاده میشود.
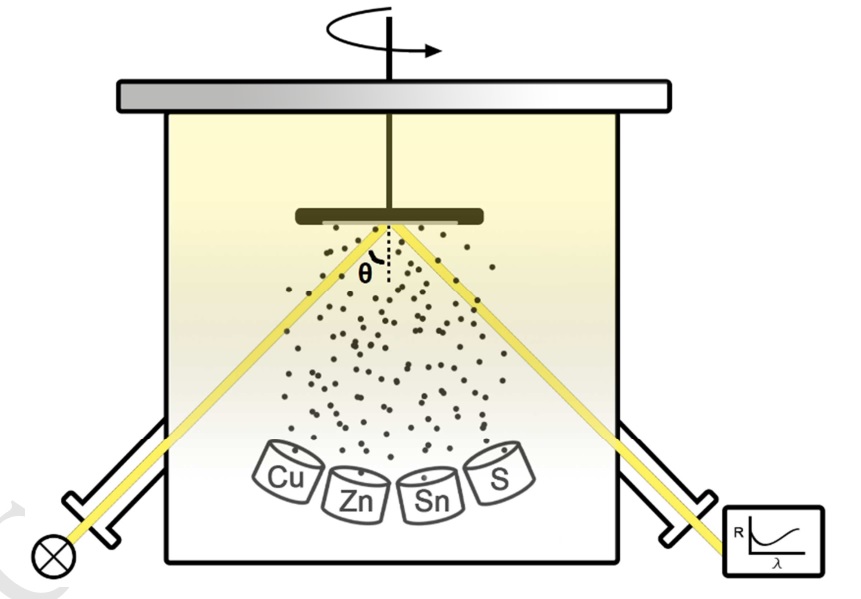
۲.۱. تداخلسنجی
تداخلسنجی یکی از دقیقترین روشها برای اندازهگیری ضخامت لایههای نازک است. در این روش، پرتوهای نور لیزر به سطح نمونه پوشیده شده توسط یک لایه نازک برخورد میکنند، که بخشی از آنها از سطح لایه و بخشی از زیرلایه شکسته میشوند و در نهایت منجر به تشکیل الگوهای تداخلی میشوند. با تجزیه و تحلیل این الگوها، میتوان ضخامت لایه را با دقت بالا محاسبه کرد. این روش به دلیل دقت بالای آن در اندازهگیری ضخامتهای کوچک (تا چند نانومتر) بسیار مورد توجه است.

۳.۱. پراش فرنل
زمانی که یک پرتو همدوس موازی از نور تک رنگ، یک لایه نازک را که به شکل پلهای روی یک زیرلایه ساخته شده و به طور یکنواخت با یک ماده بازتابنده پوشانده شده است، روشن میکند، نوارهای پراش فرنل روی صفحهای عمود بر پرتو بازتاب شده ایجاد میشوند. ضخامت لایه، زاویه تابش و طول موج نور، همگی بر میزان قابل مشاهده بودن فریزها تأثیر میگذارند. ضخامت لایه را میتوان با دقت چند نانومتر با اندازهگیری میزان دید (visibility) در مقابل زاویه تابش تعیین کرد. استفاده از این روش ساده است و نتایج بسیار قابل اعتمادی را در طیف وسیعی از ضخامتها ارائه میدهد.
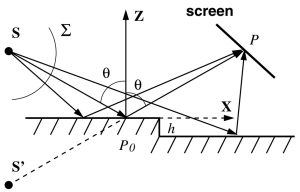
۴.۱. طیفسنجی بازتابی
این روش مبتنی بر اندازهگیری تغییرات در بازتاب پرتوهای نور با طول موجهای مختلف از سطح لایههای نازک است. هنگامی که نور به لایه نازک برخورد میکند بخشی از آن بازتاب میشود، که مقدار بازتاب با ضخامت لایه و طول موجهای نور تغییر میکند و منجر به اندازهگیری ضخامت لایه نازک میشود. این روش به ویژه برای لایههای نازک فلزی و عایقها مفید است.
۵.۱. الیپسومتری
الیپسومتری تغییر در قطبش طیف پرتو نور پس از بازتاب از سطح لایه نازک را اندازهگیری میکند و به کمک آن میتوان ضخامت لایه (در محدوده زیر نانومتر تا چند میکرون) و ثابتهای نوری آن را اندازهگیری نمود. این روش را میتوان برای نظارت بر ضخامت لایه در حین فرآیند لایهنشانی و همچنین پس از آن برای اندازهگیری ضخامت و ثابتهای نوری لایه انجام داد.
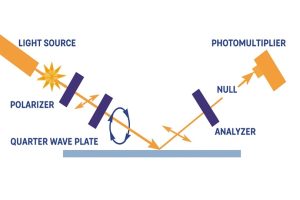
یک صفحه ربع موج، پرتو فرودی را قبل از بازتاب از لایه نازک، قطبی میکند. قطبشگر و آنالیزور به گونهای چرخانده میشوند که صفر روی فتومولتیپلایر به دست آید تا قطبش نور پس از بازتاب اندازهگیری شود.
۲. AFM و پروفایلومتری
در روشهای مکانیکی، از ابزاری برای تماس مستقیم با سطح لایه و اندازهگیری ضخامت لایههای نازک استفاده میشود.
۱.۲. میکروسکوپ نیروی اتمی (AFM)
میکروسکوپ نیروی اتمی که در سال ۱۹۸۶ معرفی شد، یکی از روشهای بررسی ساختار سطح و اندازهگیری ضخامت لایههای نازک است که توپوگرافی با وضوح بالا و اندازهگیری لایههای فوق نازک و ارتفاع پلهها را با وضوح عمودی زیر نانومتر ارائه میدهد. در این روش از یک سوزن بسیار تیز استفاده میشود که به سطح لایه نزدیک میشود و با اندازهگیری نیروی اعمال شده به سوزن، میتوان اطلاعات دقیقی در مورد ضخامت لایه و خواص سطح در نواحی کوچک (مقیاس میکرومتر) به دست آورد.
۲.۲. پروفایلومتری
پروفیلومتری قلمی (تماسی) ارتفاع پلههای لایهها را اندازهگیری میکند که میتوانند الگوسازی یا خراشیده شوند تا زیرلایه نمایان شود و با یک قلم اسکن شود تا ارتفاع پله مستقیماً خوانده شود. این روش مستقیم و از نظر ابزاری ساده است و برای پلهها از چند نانومتر تا دهها میکرومتر، با وضوح معمول چند نانومتر، دقیق است.

۳. روشهای اندازهگیری ضخامت مبتنی بر اشعه ایکس
استفاده از اشعه ایکس برای اندازهگیری ضخامت لایههای نازک یکی از روشهای پیشرفته و دقیق است. در این روش، اشعه ایکس به سطح لایه نازک تابانده میشود و میزان جذب یا پراکندگی تابش توسط لایه بررسی میشود.
۳.۳. اثرات فلورسانس پرتو ایکس
این روش میتواند به طور غیرمستقیم برای اندازهگیری ضخامت لایههای نازک استفاده شود. در این روش، تابش پرتو ایکس به سطح لایه منجر به تابش فلورسانس از عناصر موجود در لایه میشود. مقدار این تابش میتواند به ضخامت لایه مرتبط شود.
۲.۳. پراش اشعه ایکس
پراش اشعه ایکس (XRD) برای لایههای کریستالی نازک استفاده میشود. در این روش، پرتوهای ایکس به سطح لایه میرسند و از سطح آن و زیرلایه منعکس میشوند و در نتیجه الگوهای پراکندگی تشکیل میشوند. از این الگوها، میتوان اطلاعاتی در مورد ساختار کریستالی و ضخامت لایه به دست آورد.
۱.۳. بازتاب اشعه ایکس (XRR)
اندازهگیری ضخامت لایههای نازک با بازتاب اشعه ایکس، روشی با دقت بالا و غیرمخرب برای پوششهای مختلف (معمولاً ۰.۵ تا ۲۰۰ نانومتر) است که با تنظیمات مناسب قابل گسترش است. XRR با استفاده از نوارهای کیسیگ در بازتاب ناشی از برخورد پرتو در زاویه کم، ضخامت لایه، چگالی و زبری سطح مشترک را با دقت آنگستروم تا نانومتر برای لایههای یکنواخت استخراج میکند. این روش به ویژه برای اندازهگیری دقیق در لایههای نازک، یکنواخت و چندلایهها بسیار مناسب است.
۴. اندازهگیری ضخامت مقطع عرضی SEM و TEM
بررسی برش عرضی با میکروسکوپ الکترونی (SEM/TEM) میتواند اطلاعات ساختاری و اندازهگیری ضخامت لایههای نازک را ارائه دهد. مقاطع عرضی SEM که معمولاً توسط پرتو یونی متمرکز تهیه میشوند، میتوانند ضخامت فیلم را از چند نانومتر و بیشتر، با وضوح مکانی تا چند نانومتر اندازهگیری کنند، در حالی که TEM وضوح در مقیاس اتمی را برای لایههای بسیار نازک ارائه میدهد اما به مرحله آمادهسازی نمونه پیچیدهای نیاز دارد. این تکنیکها نیاز به برش عرضی نمونه دارند، بنابراین مخرب هستند، اما دادههای واضحی در مورد ضخامت و ریزساختار لایههای نازک ارائه میدهند.
۵. روشهای دیگر
هنگامی که یک سطح توسط یک لایه نازک پوشانده میشود، خواص آن ممکن است بسته به ضخامت لایه نازک تغییر کند، مانند خواص ترموالکتریک، مقاومت الکتریکی یا امواج تشدید صوتی، که میتوانند برای اندازهگیری ضخامت لایه استفاده شوند.
۱.۵. حسگرهای جرم مبتنی بر تشدیدگر (QCM)
اندازهگیری تغییرات فرکانس تشدید کریستال کوارتز (QCM) تکنیکی برای پایش درجای ضخامت و نرخ لایهنشانی در فرآیند لایهنشانی بخار فیزیکی است. حسگر ضخامت مبتنی بر کریستال QCM با افزایش جرم روی کریستال کوارتز دچار تغییر فرکانس تشدید میشود و ضخامت را از رابطه Sauerbrey، با توجه به چگالی لایه، گزارش میدهد. حسگر ضخامت QCM دارای سرعت اندازهگیری بالا است و به راحتی قابل جاسازی در محفظههای لایهنشانی است.
اندازهگیری ضخامت توسط حسگر QCM برای لایههای نازک و سفت که اثرات ویسکوالاستیک کمی دارند، دقیقتر است. این حسگرها میتوانند جرم در حد زیر تک لایه را تشخیص دهند (وضوح فرکانسی حدود ۱ هرتز روی یک کریستال ۵ مگاهرتز)، که به حساسیت ضخامت کسری از یک نانومتر (بسته به چگالی ماده) تبدیل میشود.
نکات کاربردی
روشهایی مانند تداخلسنجی و میکروسکوپ نیروی اتمی به دلیل دقت بالا و توانایی اندازهگیری ضخامتهای نانومتری، برای لایههای بسیار نازک ایدهآل هستند. با این حال، روشهایی مانند آنالیز مقاومت الکتریکی برای لایههای ضخیمتر مناسبتر هستند.
در پراش اشعه ایکس (XRD) و فلورسانس اشعه ایکس (XRF)، دقت به نوع و خواص ماده لایه و ساختار آن بسیار وابسته است. این روشها به ویژه برای لایههای کریستالی یا فلزی دقیق هستند.
در ادامه، پارامترهای مختلف روشهای مختلف اندازهگیری ضخامت لایه نازک در یک جدول مقایسه شدهاند.

نتیجهگیری
اندازهگیری ضخامت لایههای نازک بخشی مهم در فرآیندهای صنعتی و تحقیقاتی است. انتخاب روش مناسب به نوع ماده، دقت مورد نیاز و محدودیتهای فرآیند بستگی دارد. روشهای نوری درجا و خارج از محل به دلیل دقت بالا و غیر مخرب بودنشان بسیار محبوب هستند، در حالی که حسگرهای QCM بازخورد سریعی را برای کنترل سرعت ارائه میدهند. روشهای مبتنی بر اشعه ایکس مانند XRR، روشهای تماسی مانند پروفایلومتری و استفاده از میکروسکوپ الکترونی TEM/SEM در اندازهگیری مقطع عرضی معمولاً برای کالیبراسیون و اعتبارسنجی قطعات استفاده میشوند.
برخی سیستمهای خلاء پوششهای نانوساختار
منابع
- Vedam, K. (1998). Spectroscopic ellipsometry: a historical overview. Thin solid films, 313, 1-9.
- Van Duren, S., Levcenco, S., Kretzschmar, S., Just, J., & Unold, T. (2019). Investigation of reflectometry for in situ process monitoring and characterization of co-evaporated and stacked Cu-Zn-Sn-S based thin films. Journal of Alloys and Compounds, 779, 870-878.
- Ogieglo, Wojciech, et al. “Spectroscopic ellipsometry analysis of a thin film composite membrane consisting of polysulfone on a porous α-alumina support.” ACS applied materials & interfaces 4.2 (2012): 935-943.
- Review of x-ray and optical thin film measurement methods and transfer artefacts,
- Acosta, G., Allred, D. D., & Davis, R. C. (2005). A Technique for Measuring the Thin Film Thickness of Ultrathin Metallic Thin Films, 4-20 nm, using Atomic Force Microscopy. Nqhfhmk Bnmsqhatsdc@ qshbkdr9.
- Hues, S. M., Colton, R. J., Meyer, E., & Güntherodt, H. J. (1993). Scanning probe microscopy of thin films. MRS Bulletin, 18(1), 41-49.
- Maniscalco, B., Kaminski, P. M., & Walls, J. M. (2014). Thin film thickness measurements using scanning white light interferometry. Thin Solid Films, 550, 10-16.
- http://sites.science.oregonstate.edu/~tatej/TateLabWiki/lib/exe/fetch.php?media=opticalspectrometers:filmetrix_ref_technote.pdf#:~:text=The%20two%20main%20classes%20of%20thin%2D%20film,dragged%20along%20the%20surface%20of%20the%20film.
- Eckertová, L. (1977). Thin Film Thickness and Deposition Rate Measurement Methods. In: Physics of Thin Films. Springer, Boston, MA.
- Piegari, A., & Masetti, E. (1985). Thin film thickness measurement: a comparison of various techniques. Thin solid films, 124(3-4), 249-257.
- Yasaka, Miho. “X-ray thin-film measurement techniques.” The Rigaku Journal 26.2 (2010): 1-9.
- https://en.wikipedia.org/wiki/Quartz_crystal_microbalance
- https://www.azonano.com/article.aspx?ArticleID=6372
- KLA / instrument notes on stylus profilometry history and specs. KLA
- AFM history and applications (Binnig, Quate & Gerber; AFM intro). SciOpen

















